Team udvikler en følsom ny måde at detektere transistordefekter på
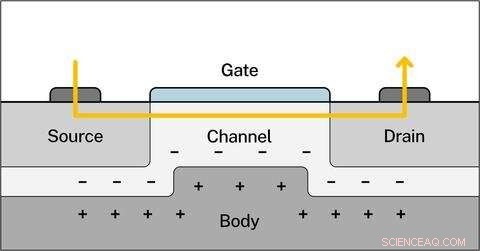
Under normal transistordrift, en ledende kanal (styret af porten) dannes mellem kilden og afløbet, lader en strøm flyde. Kredit:Sean Kelley/NIST
Forskere ved National Institute of Standards and Technology (NIST) og samarbejdspartnere har udtænkt og testet en ny, meget følsom metode til at detektere og tælle defekter i transistorer - et spørgsmål af presserende bekymring for halvlederindustrien, da den udvikler nye materialer til næste generations enheder. Disse defekter begrænser transistor- og kredsløbsydelsen og kan påvirke produktets pålidelighed.
En typisk transistor er, til de fleste anvendelser, dybest set en switch. Når det er tændt, strøm løber fra den ene side af en halvleder til den anden; slukker den stopper strømmen. Disse handlinger skaber henholdsvis de binære 1'ere og 0'ere af digital information.
Transistorydelse afhænger kritisk af, hvor pålideligt en bestemt mængde strøm vil flyde. Fejl i transistormaterialet, såsom uønskede "urenhedsområder" eller brudte kemiske bindinger, afbryde og destabilisere flowet. Disse defekter kan vise sig med det samme eller over en periode, mens enheden er i drift.
Gennem mange år, videnskabsmænd har fundet adskillige måder at klassificere og minimere disse effekter.
Men defekter bliver sværere at identificere, da transistordimensioner bliver næsten ufatteligt små og koblingshastigheder meget høje. For nogle lovende halvledermaterialer under udvikling - såsom siliciumcarbid (SiC) i stedet for silicium (Si) alene til ny højenergi, højtemperaturenheder - der har ikke været nogen enkel og ligetil måde at karakterisere defekter i detaljer.
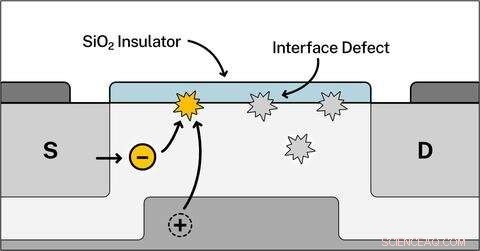
Imidlertid, elektroner, der bevæger sig fra kilden til drænet, kan støde på defekter, der fører til rekombination med et hul, resulterer i et tab af strøm og gør transistoren upålidelig. De vigtigste af disse kaldes grænsefladedefekter, eksisterer ved grænsefladen mellem siliciumoxid- og siliciumlagene. Kredit:Sean Kelley/NIST
"Den metode, vi udviklede, fungerer med både traditionel Si og SiC, giver os for første gang mulighed for at identificere ikke kun typen af defekt, men antallet af dem i et givet rum med en simpel DC-måling, " sagde NISTs James Ashton, som udførte forskningen sammen med kolleger ved NIST og Pennsylvania State University. De offentliggjorde deres resultater den 6. oktober i Journal of Applied Physics . Forskningen fokuserer på interaktioner mellem de to slags elektriske ladningsbærere i en transistor:Negativt ladede elektroner og positivt ladede "huller, " som er rum, hvor der mangler en elektron i den lokale atomare struktur.

For at tælle disse mangler, forskere placerer transistoren i "bipolær forstærkningstilstand" ved at påføre en spænding til kilden og porten. Dette skaber en faldende koncentration af elektroner på tværs af kanalen. I denne konfiguration, strømmen fra kilden til drænet er meget følsom over for grænsefladedefekter. Kredit:Sean Kelley/NIST
Når en transistor fungerer korrekt, en specifik elektronstrøm løber langs den ønskede vej. (Huller kan også danne en strøm. Denne forskning udforskede elektronstrøm, det mest almindelige arrangement.) Hvis strømmen støder på en defekt, elektroner fanges eller forskydes, og kan derefter kombineres med huller for at danne et elektrisk neutralt område i en proces kendt som rekombination.
Hver rekombination fjerner en elektron fra strømmen. Flere defekter forårsager strømtab, der fører til funktionsfejl. Målet er at afgøre, hvor fejlene er, deres specifikke virkninger, og - ideelt set - antallet af dem.
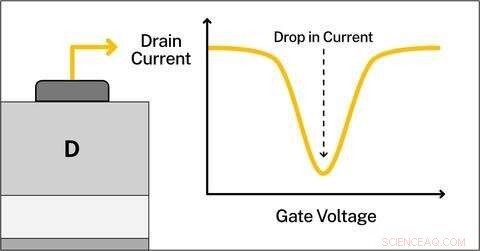
Ved at overvåge strømmen ved afløbet, mens portspændingen varieres, forskere kan nøjagtigt bestemme antallet af defekter fra faldet i strømmen. Kredit:Sean Kelley/NIST
"Vi ønskede at give producenterne en måde at identificere og kvantificere defekter, mens de tester forskellige nye materialer, " sagde NIST-medforfatter Jason Ryan. "Vi gjorde det ved at skabe en fysikmodel af en defektdetektionsteknik, der har været meget brugt, men dårligt forstået indtil nu. Vi udførte derefter proof-of-principle eksperimenter, der bekræftede vores model."
I et klassisk metaloxid-halvlederdesign (se figur), en metalelektrode kaldet gate er placeret oven på et tyndt isolerende siliciumdioxidlag. Under denne grænseflade er hoveddelen af halvlederen.
På den ene side af porten er der en indgangsterminal, kaldet kilden; på den anden er en udgang (dræn). Forskere undersøger dynamikken i strømstrømmen ved at ændre "bias" spændingerne påført til porten, kilde og afløb, som alle påvirker, hvordan strømmen bevæger sig.
I det nye værk, forskerne fra NIST og Penn State koncentrerede sig om en bestemt region, der typisk kun er omkring 1 milliardtedel meter tyk og en milliontedel meter lang:Grænsen, eller kanal, mellem det tynde oxidlag og bulkhalvlederlegemet.
"Dette lag er enormt vigtigt, fordi effekten af en spænding på metaloverfladen af transistorens oxid ændrer, hvor mange elektroner der er inden for kanalområdet under oxidet; denne region styrer modstanden af enheden fra kilde til dræn, " Ashton sagde. "Ydeevnen af dette lag er afhængig af hvor mange defekter der findes. Detektionsmetoden, vi undersøgte, var tidligere ude af stand til at bestemme, hvor mange defekter der var inden for dette lag."
En følsom metode til at opdage defekter i kanalen kaldes elektrisk detekteret magnetisk resonans (EDMR), som i princippet ligner medicinsk MR. Partikler som protoner og elektroner har en kvanteegenskab kaldet spin, hvilket får dem til at fungere som bittesmå stangmagneter med to modsatte magnetiske poler. I EDMR, transistoren bestråles med mikrobølger med en frekvens omkring fire gange højere end en mikrobølgeovn. Eksperimentører anvender et magnetfelt på enheden og varierer gradvist dens styrke, mens de måler udgangsstrømmen.
Ved den helt rigtige kombination af frekvens og feltstyrke, elektroner ved defekter "vender" - vender deres poler. Dette får nogle til at miste nok energi til at de rekombinerer med huller ved defekter i kanalen, reducere strømmen. Kanalaktiviteten kan være svær at måle, imidlertid, fordi den høje mængde "støj" fra rekombination i hovedparten af halvlederen.
For udelukkende at fokusere på aktivitet i kanalen, forskere bruger en teknik kaldet bipolar amplification effect (BAE), hvilket opnås ved at arrangere de forspændinger, der påføres kilden, port og afløb i en bestemt konfiguration (se figur). "Så på grund af den biasing, vi bruger i BAE, og fordi vi måler strømniveauer ved afløbet, Ashton sagde, "Vi kan eliminere interferens fra andre ting, der foregår i transistoren. Vi kan kun vælge defekter, som vi bekymrer os om i kanalen."
Den nøjagtige mekanisme, som BAE opererer med, var ikke kendt, før holdet udviklede sin model. "De eneste måleresultater var kvalitative - dvs. de kunne fortælle den slags defekter i kanalen, men ikke antallet, " sagde medforfatter Patrick Lenahan, en fremtrædende professor i ingeniørvidenskab og mekanik ved Penn State.
Før modellen af BAE, ordningen blev udelukkende brugt som en ressource til påføring af spændinger og styring af strømme til EDMR-målinger, hvilket er nyttigt til en mere kvalitativ defektidentifikation. Den nye model gør det muligt for BAE som et værktøj at kvantitativt måle antallet af defekter og at gøre det med kun strømme og spændinger. Den vigtige parameter er grænsefladedefektdensiteten, som er et tal, der beskriver, hvor mange defekter der er inden for et område af halvleder-oxid-grænsefladen. BAE-modellen giver forskerne en matematisk beskrivelse af, hvordan BAE-strømmen hænger sammen med defekttætheden.
Modellen, som forskerne testede i et sæt proof-of-concept-eksperimenter på metaloxid-halvledertransistorer, gør kvantitative målinger mulige. "Nu kan vi redegøre for variationen i afgiftsoperatørdistribution i hele kanalregionen, " sagde Ashton. "Dette åbner op for mulighederne for, hvad der kan måles med en simpel elektrisk måling."
"Denne teknik kan give en unik indsigt i tilstedeværelsen af disse destabiliserende transistordefekter og en vej til mekanistisk forståelse af deres dannelse, sagde Markus Kuhn, tidligere hos Intel og nu seniordirektør for halvledermetrologi og fellow hos Rigaku, som ikke var involveret i undersøgelsen. "Med sådan viden, der ville være større mulighed for at kontrollere og reducere dem for at forbedre transistorydelsen og pålideligheden. Dette ville være en mulighed for yderligere at forbedre design af chipkredsløbet og enhedens ydeevne, hvilket fører til bedre ydende produkter."
Denne historie er genudgivet med tilladelse fra NIST. Læs den originale historie her.
Sidste artikelRidning på bølgerne holder ænder på række
Næste artikelEn ny teori til at teste hypoteser og metoder til exoplanetdetektion
 Varme artikler
Varme artikler
-
 sPHENIX får CD0 til opgradering til at eksperimentere med at spore stoffets byggestenMagnetmagneten, der danner kernen i sPHENIX-detektoren. Kredit:US Department of Energy Det amerikanske energiministerium (DOE) har givet Critical Decision-Zero (CD-0) status til sPHENIX-projektet,
sPHENIX får CD0 til opgradering til at eksperimentere med at spore stoffets byggestenMagnetmagneten, der danner kernen i sPHENIX-detektoren. Kredit:US Department of Energy Det amerikanske energiministerium (DOE) har givet Critical Decision-Zero (CD-0) status til sPHENIX-projektet, -
 Brug af hydrogenioner til at manipulere magnetisme på molekylær skalaNSLS-II-videnskabsmanden Wen Hu (i midten) arbejder sammen med MIT-forskere Mantao Huang (til venstre) og Aik Jun Tan (til højre) ved Coherent Soft X-Ray Scattering (CSX) beamline. Kredit:Brookhaven N
Brug af hydrogenioner til at manipulere magnetisme på molekylær skalaNSLS-II-videnskabsmanden Wen Hu (i midten) arbejder sammen med MIT-forskere Mantao Huang (til venstre) og Aik Jun Tan (til højre) ved Coherent Soft X-Ray Scattering (CSX) beamline. Kredit:Brookhaven N -
 Rekordstor terahertz laserstråleClaudia Gollner og hendes lasersystem. Kredit:Vienna University of Technology Terahertz-stråling bruges til sikkerhedstjek i lufthavne, til lægeundersøgelser og også til kvalitetstjek i industrien
Rekordstor terahertz laserstråleClaudia Gollner og hendes lasersystem. Kredit:Vienna University of Technology Terahertz-stråling bruges til sikkerhedstjek i lufthavne, til lægeundersøgelser og også til kvalitetstjek i industrien -
 Kryptografi uden brug af hemmelige nøglerDe fleste sikkerhedsapplikationer, for eksempel, adgang til bygninger eller digitale signaturer, bruge kryptografiske nøgler, der for enhver pris skal holdes hemmelige. Det er også det svage led:Hvem
Kryptografi uden brug af hemmelige nøglerDe fleste sikkerhedsapplikationer, for eksempel, adgang til bygninger eller digitale signaturer, bruge kryptografiske nøgler, der for enhver pris skal holdes hemmelige. Det er også det svage led:Hvem
- Tæthedsudsving i solvinden baseret på type III radioudbrud
- Sådan får du din bils sikkerhedsfunktioner til at fungere for dig
- Ny undersøgelse viser fordele ved radiosignaler fra årtier gammel teori
- Kemikere udvikler hydrogelstrenge ved hjælp af forbindelse fundet i havdyr
- Andromedas lyse røntgenmysterium løst af NuSTAR
- Varmestress eskalerer i byer under global opvarmning


