3D-stressanalysesimulator til ultra-små siliciumenheder afsløret
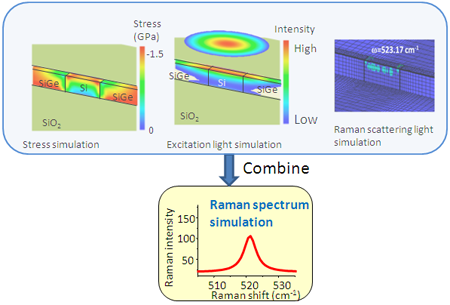
Skematisk diagram over den udviklede simuleringsteknologi.
National Institute of Advanced Industrial Science and Technology (AIST) -forskere har udviklet en tredimensionel stressanalysesimulator til ultra-små silicium (Si) -enheder. Den udviklede simuleringsteknologi gør det muligt at analysere fordelingen af den mekaniske spænding (eller mekaniske belastning), der påføres ultra-små Si-enheder med en rumlig opløsning på nanometer-niveau ved at beregne moduleringen af lysintensitetsfordelingen forårsaget af enhedens struktur i mikroen -Raman spektroskopimåling ved hjælp af et optisk mikroskop.
Teknologien forventes at bidrage til at forbedre hastigheden og reducere strømforbruget på førende LSI-enheder, især tredimensionelle FinFET-enheder, der vil blive vedtaget ved 22 nm teknologienoden.
Inden for avancerede halvlederanordninger, højere hastighed og højere ydeevne er blevet realiseret ved bevidst at påføre stress på kanalområder, hvor bærere som elektroner og huller flyder, at øge transportørens mobilitet. Hvis, imidlertid, der er udsving i stress, transistorernes ydeevne svinger, gør det vanskeligt at reducere driftsspændingen tilstrækkeligt og, følgelig, gør det umuligt at reducere strømforbruget. Det er derfor, det er nødvendigt at undertrykke udsving i spændingen for at reducere strømforbruget på disse enheder. På denne baggrund, en metode til at evaluere spændingsfordelingen i en enhed med en høj rumlig opløsning er nødvendig for at vurdere stressens indflydelse på enhedens ydeevne, at afklare forholdet mellem enhedens struktur og belastningen og, dermed, at afspejle sådanne oplysninger i enhedens strukturelle design og produktionsprocesser.

Figur 1:Flowchart af den udviklede tredimensionelle stressanalysesimulator.
I MIRAI -projektet AIST gennemførte forskning og udvikling af en måleteknologi til lokal stressfordeling i Si-enheder ved hjælp af mikro-Raman-spektroskopi. Det har opnået rumlig opløsning i verdensklasse i en stressfordelingsanalyse teknologi ved hjælp af Raman-spektroskopi. For eksempel, den har udviklet en evalueringsteknologi til lokal stressfordeling ved en rumlig opløsning på 100 nm eller mindre, som er kortere end lysets bølgelængde. Under forskning og udvikling, det blev konstateret, at lysintensitetsfordelingen i en ultrasmå enhed var stærkt moduleret i nanometerskalaen og dermed blev Raman-spektret påvirket kraftigt. I den nuværende forskning, en metode, der er i stand til at evaluere kvantitativ stressfordeling i nanometerskalaen, er blevet udviklet baseret på analyse af Raman -spektroskopi, der afspejler effekten af lysmodulation, som beregnes med en simuleringsteknologi, der integrerer elektromagnetisk feltanalyse og stressanalyse, kombineret med teknologi CAD.
Micro-Raman spektroskopi muliggør ikke-destruktiv stressmåling ved hjælp af et fænomen, hvorved, når excitationslysindfald på en prøve er spredt, bølgelængden af de spredte lysforskydninger, der afspejler energiniveauer af gittervibrationer osv. mikro-Raman-spektroskopi anses for at være en lovende metode til evaluering af stressfordeling. Afhængig af intensiteten og retningen af belastningen på en prøve, bølgelængdeforskydningen af Raman, der spreder lys (Raman -skift, som normalt udtrykkes i bølgetal) varierer. Derfor, det er muligt kvalitativt at estimere stress ved at måle variationen af Raman -skift. Imidlertid, fordi der bruges et optisk mikroskop, den rumlige opløsning er begrænset til lysets bølgelængde (fra flere hundrede nanometer til et mikrometer). Ud over, da stress er en fysisk mængde bestående af seks uafhængige komponenter, kvantitativ vurdering af stress, herunder dens retning og type, er vanskelig kun med Raman -måling. En konventionel løsning på dette problem har været at evaluere stressfordeling ved at sammenligne resultaterne af stresssimuleringer og mikro-Raman-målinger. Ved målinger af ultra-små enheder, imidlertid, deres enhedsstruktur modulerer komplekst lysudbredelse i nanometerskalaen, forårsager stor indflydelse på det målte Raman -spektrum, og derfor gør det umuligt at udføre nøjagtig stressanalyse.

(Figur 2:(a) Spændingsfordeling af FinFET -strukturen og intensitetsfordeling af excitationslys beregnet af det udviklede system (b) Raman -spredning af lys for hver bølgelængde fra sidevæggen og (c) spektrum af hvert spredningslys opnået fra analyse og det kombinerede Raman -spektrum.
Det udviklede simuleringssystem kombinerede beregningen af spredning af excitationslys og spredning af lys i en Raman-måling ved elektromagnetisk simulering ved hjælp af finite-difference time-domain metoden (FDTD) og stressanalyse ved hjælp af finite element metoden (FEM). Dette muliggør en nøjagtig beregning af Raman -spektret, der afspejler nanometer -skala -moduleringseffekten i lysintensitetsfordeling på grund af enhedens struktur, og en kvantitativ beregning af spændingsfordeling i enheden.
Figur 1 viser et rutediagram over den udviklede tredimensionelle stressanalysesimulator. Den overordnede struktur består af 1) struktur- og spændingsaflæsningsenheden (beregner spændingsfordeling baseret på FEM -metoden); 2) den tredimensionelle FDTD-analyseenhed (beregner intensitetsfordelingen af excitationslys); 3) Raman shift analyseenheden (beregner bølgelængden af Raman, der spreder lys fra forskellige punkter på en prøve baseret på spændingsfordeling); 4) den tredimensionelle FDTD-analyseenhed (beregner Raman-spredningslys fra prøven); og 5) Raman -spektrumanalyseenheden (beregner Raman -spektre i bølgelængdeområder, der faktisk måles). Analyseresultaterne visualiseres af en tredimensionel fremviser. Figur 2 (a) viser spændingsfordelingen af FinFET og intensitetsfordelingen af excitationslys beregnet med den udviklede simulator. En Si-kanal dannet på et siliciumdioxid (SiO2) lag er under stress af en silicium-germaniumlegering (SiGe) i begge ender. Intensitetsfordelingen af excitationslys moduleres af prøvestrukturen; intensiteten af excitationslys tæt på kanalens kant er særlig stærk, så det spredende lys fra området tæt på kanten bidrager betydeligt til det målte Raman -spredningslys. Excitationslyset er bøjet og belyser sidevæggen. Figur 2 (b) viser Raman -spredningslyset for hver bølgelængde fra Si -kanalen. Da stressintensiteten varierer afhængigt af placeringen, Ramans spredningslys udsendes følgelig ved forskellige bølgelængder. Figur 2 (c) viser spektret for hvert Raman -spredningslys opnået fra analysen, og disse spektre blev kombineret til dannelse af et Raman -spektrum. Dette kombinerede spektrum svarer til det faktisk målte Raman -spektrum. Stressanalysen justeres, indtil forskellen fra det målte spektrum forsvinder, og dermed, den endelige værdi af stress bestemmes med simuleringen.
Den rumlige opløsning af mikro-Raman-spektroskopi er generelt begrænset til bølgelængden af excitationslys (fra flere hundrede nanometer til et mikrometer). På den anden side, det udviklede system, som laver nøjagtige Raman -simuleringer, er i stand til at estimere og evaluere stressfordeling med en rumlig opløsning i nanometerskalaen.
Forskerne sigter mod at yde yderligere bidrag til samfundet, såsom kommercialisering af Raman -målesystemet, der indeholder den udviklede måle- og evalueringsteknologi.
 Varme artikler
Varme artikler
-
 Forskere udvikler stabilt selvlysende kompositmateriale baseret på perovskit -nanokrystallerArtikel Illustration, Stabile selvlysende kompositmikrosfærer baseret på porøs silica med indlejrede CsPbBr3 perovskit -nanokrystaller Kredit:ChemNanoMat Et internationalt team af forskere, der om
Forskere udvikler stabilt selvlysende kompositmateriale baseret på perovskit -nanokrystallerArtikel Illustration, Stabile selvlysende kompositmikrosfærer baseret på porøs silica med indlejrede CsPbBr3 perovskit -nanokrystaller Kredit:ChemNanoMat Et internationalt team af forskere, der om -
 Forskere omfavner ufuldkommenhed for at forbedre biomolekyletransportLaboratorie-konstruerede membrandefekter med kanter, der spiraler nedad, ville give biomolekyler som DNA, RNA og proteiner ingen anden mulighed end at synke ned i en nanopore til levering, sortering o
Forskere omfavner ufuldkommenhed for at forbedre biomolekyletransportLaboratorie-konstruerede membrandefekter med kanter, der spiraler nedad, ville give biomolekyler som DNA, RNA og proteiner ingen anden mulighed end at synke ned i en nanopore til levering, sortering o -
 Chip-baseret digital PCR-detektionsteknologi og instrument udvikletFig. Workflowdiagram af nano-dLAMP-detektionssystemet. Kredit:SIBET Et fælles hold fra Kina leverede for nylig en følsom, multipleksing, kvantitativ detektionsmetode til tidlig diagnose og målrett
Chip-baseret digital PCR-detektionsteknologi og instrument udvikletFig. Workflowdiagram af nano-dLAMP-detektionssystemet. Kredit:SIBET Et fælles hold fra Kina leverede for nylig en følsom, multipleksing, kvantitativ detektionsmetode til tidlig diagnose og målrett -
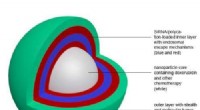 Nye nanopartikler svækker tumorcelleforsvar, derefter strejke med kemoterapi stofSkematisk tegning af en ny nanopartikel udviklet på MIT. Kredit:FORSKERNE En aggressiv form for brystkræft kendt som triple negative er meget vanskelig at behandle:Kemoterapi kan formindske sådann
Nye nanopartikler svækker tumorcelleforsvar, derefter strejke med kemoterapi stofSkematisk tegning af en ny nanopartikel udviklet på MIT. Kredit:FORSKERNE En aggressiv form for brystkræft kendt som triple negative er meget vanskelig at behandle:Kemoterapi kan formindske sådann
- Fordele og ulemper ved plastiske gear
- Nye nanotweezer åbner døren til innovationer inden for medicin, mobil teknologi
- Neolitisk byggeboom førte til, at storskala megahenger blev bygget over det sydlige Storbritannien,…
- Fermi finder mulige mørkt stof-bånd i Andromeda-galaksen
- Udtalelse:Hvorfor alle børn skal lære kode
- Forsker finder et matematisk mønster i menneskelig konflikt ved hjælp af datavidenskab


